
关键词:#低温固化环氧树脂导电银胶#低温银胶#芯片导电胶#半导体封装导电银胶 #环氧树脂导电胶#单组份导电银胶#80度固化导电胶#光学导电胶#高粘接强度银胶#医疗低温导电银胶
摘要 (Abstract)
在半导体封装与精密电子元器件组装领域,随着热敏器件(如MEMS、光电传感器、晶振)的广泛应用,传统高温回流焊工艺已面临热预算超标的瓶颈。低温固化导电银胶(Low Temperature Curing ECA) 作为一种关键的互连材料,能够在 60°C-80°C 的温和条件下实现电气导通与机械粘接。本文将深入探讨峻茂环氧树脂基导电银胶的材料特性,重点分析其在低体积电阻率与高剪切强度方面的性能表现,并阐述其在芯片粘接(Die Attach)与精密元器件组装中的工程应用价值。
一、 行业背景:热敏器件对低温互连工艺的刚性需求
在电子制造工艺中,无铅焊锡(Lead-free Solder)的回流焊温度通常高达 240°C-260°C左右。然而,越来越多的新型电子元器件无法承受如此高的热冲击:
- 温度敏感型芯片:部分 CMOS 图像传感器(CIS)、微机电系统(MEMS)、生命医疗传感器及生物芯片,高温会导致内部结构应力释放,引起精度漂移或功能失效。
- 热敏基材:柔性电路板(FPC)使用的 PET 基材,以及部分精密注塑件(如 PC、ABS),耐温极限通常低于150°C。
- 精密无源器件:某些高精度晶体振荡器(TCXO)或声表面波滤波器(SAW),高温作业会破坏其封装气密性或改变压电特性。
针对上述问题,低温固化导电银胶可能成为替代焊锡的唯一可行方案。它要求材料必须在 80°C 以下完成交联固化,同时提供足以媲美焊锡的导电性与可靠性。
二、 材料科学:低温固化导电胶的配方逻辑
市面常规导电胶通常需要 120°C-160°C 才能固化。峻茂通过对环氧树脂(Epoxy Resin)基体与导电填料(Conductive Filler)的微观调控,实现了工艺温度窗口的下探。
2.1 潜伏性固化体系与低温反应动力学
峻茂采用了特殊的改性胺类潜伏性固化剂。该固化剂在室温下处于休眠状态(保证储存期),一旦温度达到 60°C-80°C 阈值,即迅速解封并引发环氧基团的开环聚合反应。
- 工程意义: 实现在60度或80度条件下的完全固化,有效保护了热敏元器件,同时降低了生产能耗。
2.2 银粉级配与逾渗阈值(Percolation Threshold)
为了在低温固化(聚合物收缩率较小)的情况下依然获得低电阻,峻茂优化了银粉的形貌与粒径分布。
- 微观结构: 采用片状银粉(Flakes)与球状银粉(Spheres)的混合级配。片状银粉在固化过程中通过层叠排列,构建了高效的电子传输通道。
- 性能指标: 固化后的体积电阻率稳定在 10⁻⁴ Ω·cm 数量级,满足信号传输与接地屏蔽(Grounding)的严苛要求。
三、 核心性能指标解析
对于采购和工程人员而言,评估一款低温导电胶的性能,技术上主要考量以下三个核心维度的实测数据。
3.1 优异的电学性能(低电阻)
传统低温胶常因固化不完全或银粉接触不够紧密导致电阻偏高。峻茂产品通过配方优化,确保在80度固化条件下,树脂基体能充分收缩压紧银粉,形成稳定的导电网络。
- 实测数据: 峻茂低温导电胶系列在 80°C 固化后,体积电阻率可达 0.0003 Ω·cm,且在 85°C/85%RH 双85老化测试 1000 小时后,电阻变化率小于 20%。
3.2 卓越的力学性能(高粘接力)
环氧树脂体系赋予了胶水优异的内聚力(Cohesion)与附着力(Adhesion)。即便在低温固化条件下,峻茂导电胶对镀金、镀银、铜及 FR4、陶瓷基板均表现出极高的剪切强度。
- 实测数据: 芯片剪切强度(Die Shear Strength)通常 > 10 MPa(@25°C),有效防止元器件在震动或跌落测试中脱落。
3.3 适配的耐温性能(150°C)
基于环氧树脂的物理特性,低温固化导电胶的玻璃化转变温度(Tg)通常较低。但是峻茂低温导电胶产品的连续工作温度设计为 -40°C 至 150°C。
- 工程建议: 此耐温范围完全覆盖了绝大多数消费电子、工业控制及部分汽车电子(非动力域)的工况需求。对于超过 150°C 的极端高温应用,建议选用峻茂的高温导电胶系列。
四、 关键应用场景技术方案
峻茂低温导电银胶已在以下高精密领域验证了其工艺可靠性。
4.1 半导体芯片粘接 (Die Attach)
在 RFID 电子标签、智能卡(Smart Card)及部分 MEMS 传感器封装中,芯片直接贴装于 PET 或 PVC 基材上。
- 技术挑战: 基材受热易变形,导致芯片位移。
- 解决方案: 使用峻茂80度固化导电胶,配合高速点胶工艺。其触变性(Thixotropy)经过专门调教,确保胶点高度一致,无塌陷,固化后应力低,不损伤芯片。
4.2 精密电子元器件组装
针对石英晶体振荡器(Crystal Oscillator)、滤波器及电感线圈的内部连接。
- 技术挑战: 高温会改变晶体的压电效应频率。
- 解决方案: 80°C 低温固化工艺完全避开了晶体的频率漂移区间。峻茂导电胶提供极低的接触电阻,确保元器件电气性能的稳定性。
4.3 光电模组与光学模组
在摄像头模组的感光元件组装及光电芯片。
- 技术挑战: 必须避免挥发物污染光学组件,且需在低温下固化以防止支架组件变形。
- 解决方案: 峻茂导电胶采用无溶剂配方,固化过程无低分子挥发,杜绝了光学污染风险,同时满足低温快速组装需求。
4.4 生命科学与医疗电子
可穿戴式葡萄糖监测仪、智能助听器、ECG/EEG生命体征监测等医疗传感器件。
- 技术挑战: 它们都具有潜在的“可穿戴性”,必须能够感知患者身体的化学和物理变化,用于感知患者运动的成品组件,通常会使用柔性材料,这些组件可能会在使用传统组装方式过程中受损。
- 解决方案: 峻茂的低温导电银胶具有低模量和低CTE特性。它就像一个“弹性缓冲区”,在可延展的聚合物基质中均匀分布银填料。当基板变形时,胶层能通过自身的微观形变释放应力,而不是产生裂纹。这对于需要频繁运动的智能创可贴、助听器、步态监测、血氧监测……至关重要。
五、 结语
在精密电子制造向微型化、集成化发展的今天,低温互连技术已成为保护热敏元器件、提升良率的关键一环。峻茂新材料依托成熟的环氧树脂改性技术,为行业提供了 60°C-80度低温固化、高粘接推力、低电阻率的导电银胶解决方案。我们致力于协助客户在严苛的热固化限制下,实现高可靠性的电气与机械互连。
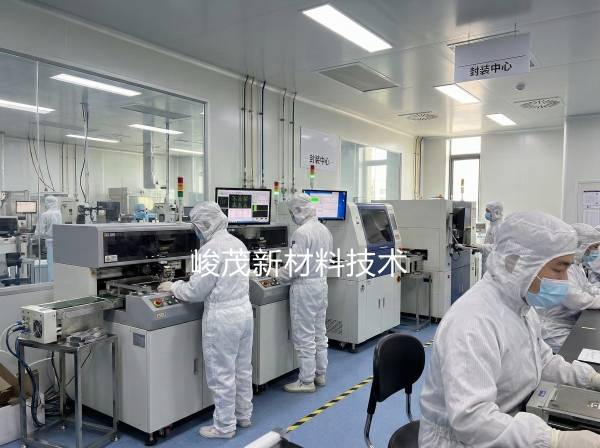 峻茂胶粘剂在半导体封装的应用
峻茂胶粘剂在半导体封装的应用
)

)
)
)
)
)

)
)
)


)
)
)